Wafer & Materials
Wafer
반도체에서 사용되는 Silicon base substrate와 LED에 사용되는 Sapphire base substrate를 주로 판매하고 있습니다.
Wafer는 반도체 또는 LED에서 chip을 제조하기위한 기판(Substrate)으로 device에 알맞은 기판을 선택하여야 최적의 결과를 얻을 수 있습니다.
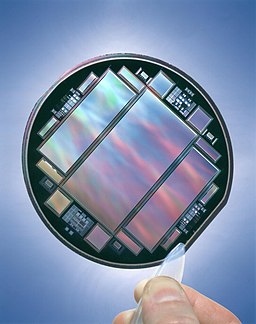
Silicon Wafer
| Growing method | CA |
|---|---|
| Grade | PRIME, TEST, DUMMY |
| Type | P-type(Boron), N-type(Phos, Antimony, Arsenic) |
| Orientation | <100>, <111>, <110> |
| Resistivity | 0.001 ~ 0.1Ωcm, 1 ~ 30Ωcm, 100 ~ 10000Ωcm |
| Thickness | 275±25µm, 525±25µm, 675±25µm, 725±25µm, 750±25µm |
| Surface | SSP & DSP |
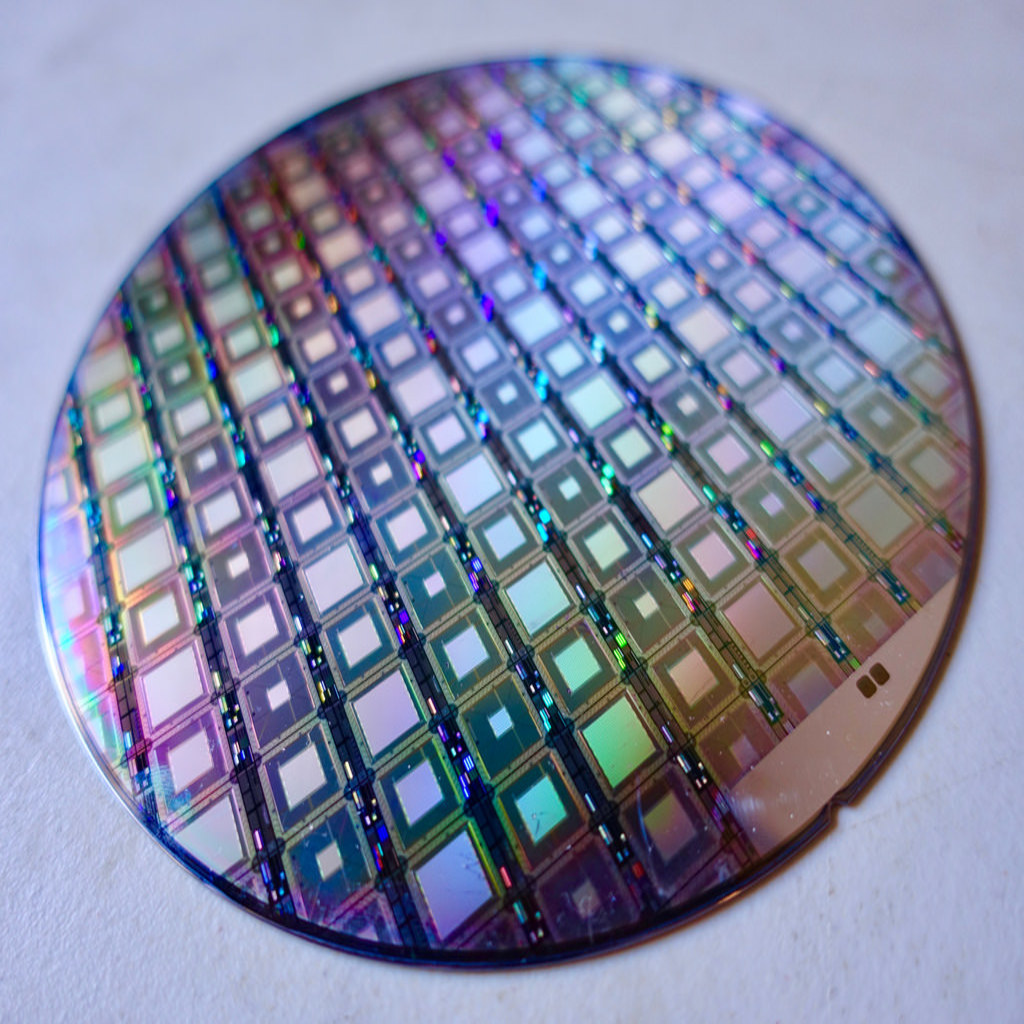
Sapphire Wafer
| Growing method | KY, HEM |
|---|---|
| Orientation | C-axis[0001] |
| Thickness | 430±10µm, 660±10µm, 1300±10µm |
| Surface | Front side : Epi-ready, PSS surface |

* Sliicon wafer의 경우 CMP 추가 공정을 하여 두께 50µm 이상부터 원하시는 Thickness로 공급 가능
* TTV (Total Thickness Variation) : < 15µm 이지만, CMP공정 추가로 최소 2µm까지 공정 가능
* SOI (Silicon On Insulator), SOG (Silicon On Glass), SOQ (Silicon On Quartz) 제작 가능
Chemical
Cleaning, Etching 등의 반도체 제조 공정에서 다양한 Chemical이 사용됩니다.

성분 : NH4OH / H2O2 / H2O
주요용도 : 파티클제거
암모니아(NH4OH), 과산화수소(H2O2) 그리고 DI(H2O)을 1:1:5 의 비율로 혼합하여 75~90℃의 온도에서 cleaning을 실시하는데 H2O2가 H2O와 O2로 분리되어 강한 산화작용으로 표면 유기 물질들이 물에 잘 용해될 수 있도록 합니다.
주로 파티클을 제거하며 또한 표면의 유기 오염물과 Au, Ag, Cu, Ni, Cd, Zn,Co,Cr 등과 같은 잔존금속 불순물을 제거하는 목적으로 사용합니다.
성분 : HCl / H2O2 / H2O
주요용도 : 금속불순물제거
염산(HCl), 과수(H2O2)와 DI(H2O)를 1:1:5등의 비율로 혼합하여 75~85℃에서 진행하는 공정입니다.
75~85℃를 이용하는 이유는 세정액을 충분히 활성화 할 수 있는 동시에 과산화수소의 분해가 급속히 진행되지 않은 온도이기 때문입니다. 또한 세정 후에는 표면에 15Å정도의 화학적 산화막이 형성되고 표면은 친수성 특성을 나타냅니다. 금속 오염물질과 알카리 금속들을 제거하는 데 효과적입니다.
성분 : H2SO4 / H2O2
주요용도 : 유기물제거
황산(H2SO4)와 과산화수소(H2O2)를 4:1등의 비율로 혼합하여 90~130℃에서 진행하는 공정입니다.
이는 웨이퍼 표면의 유기 오염물을 제거하기 위해 사용되며, 특히 포토레지스트와 같은 heavy 유기 오염물을 효과적으로 제거하며 세정 후 화학적 산화막을 형성시키고 기판 표면은 친수성을 나타냅니다.
| 공정 | 성분 | 주요용도 |
|---|---|---|
| Etching | H3PO4 / H2O | Si3N4 Etching |
| HNO3 / HF / H2O(/CH3COOH) | Si Etching | |
| H3PO4 / HNO3 / CH3COOH / H2O | Ai Etching | |
| NH4F / HF / H2O | SiO2 Etching | |
| Resist 박리액 | Resist 박리 | |
| 폴리머 제거액 | Etching 생성물 등 제거 | |
| CMP 후 세정액 | 슬러리 금속미립자 제거 | |
| 현상액 (TMAH) | Resist 현상 |
| # | 품명 | 단위 |
|---|---|---|
| 1 | 염산(HCl) | Gal |
| 2 | 암모니아수(NH4OH) | Gal |
| 3 | 질산(HNO3) | Gal |
| 4 | Hydrogen Peroxide(H2O2) | Gal |
| 5 | Nano-strip2x | Gal |
| 6 | IPA | Gal |
| 7 | IPA | 20L |
| 8 | Sulfuric Acid(H2SO4) | 20L |
| 9 | Acetone | 20L |
| 10 | BOE 20:1 | 20L |
| 11 | BOE 6:1 | 20L |
| 12 | 인쇄탈막제 (ASP-S202) | 20L |